首頁 設備
設備

活化能量測系統
Ea
儀器管理員:蘇育右
聯絡電話:(04)22851549#902
儀器概述
活化能(Ea)值可由試片上蒸鍍兩平行長方條金屬電極分別以不照光、照光、及不照光並加熱試片等方式進行電流電壓(I-V)特性測量及分析。活化能Ea值之測量是在黑箱中改變試片之溫度測量不同溫度值之暗電導σ(T),一般測量時溫度變化範圍約在50℃至150℃之間。活化能Ea值可由ln(σ(T))對1/T 做圖之斜率求得。
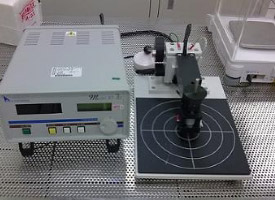
四點探針
four point probe tester
儀器管理員:周敬添
聯絡電話:(04)22851549#725
儀器概述
- 可量薄膜的電阻係數及片電阻值
- 利用外側兩探針間加固定電流,並同時量測另外兩個內探針間之相對電壓計算其電性

橢圓儀
Ellipseometer
儀器管理員:周敬添
聯絡電話:(04)22851549#725
儀器概述
可以用來測量薄膜的偏振特性及色散特性,特別是可研究薄膜生長的初始階段並用以計算分子層的厚度及密度等 。

霍爾量測
Hall Effect Measurement System
儀器管理員:周敬添
聯絡電話:(04)22851549#725
儀器概述
半導體材料中電阻率(resistivity) 、載子濃度(carrier concentration)與遷移率(mobility),是量測材料電性的重要依據,而霍爾效應則提供了一個結構簡單、使用方便與成本低廉的方式來得到這些電性資訊,並可以鑑別一個半導體材料是屬於n 型或p 型,因此普遍的被應用在半導體工業和研究室中。

紫外光可見光吸收光譜儀
UV-VIS(UV-VIS Spectrometer)
儀器管理員:蘇育右
聯絡電話:(04)22851549#902
儀器概述
紫外光可見光吸收光譜儀乃是利用可見光及紫外光之燈管做為光源,通過濾光鏡調整色調後,經聚焦後通過單色光分光稜鏡,再經過狹縫選擇波長,使成單一且特定波 長之光線,而後射入樣品管中之水樣中,最後射入光電管中將光能轉換為電器訊號,藉由樣本及空白水樣間所吸收之光能量差,與標準液之能量吸收值相比較,便可 律定樣本中之待測物濃度。

傅立葉轉換紅外線光譜儀
FTIR(Fourier transform infrared spectroscopy)儀器管理員:蘇育右
聯絡電話:(04)22851549#902
儀器概述
傅立葉轉換紅外線光譜儀的心臟是干涉儀、包含了光束分離、不動鏡像、移動鏡像。從兩個鏡像的光反射製造一個干擾,由傅立葉轉換分析了干擾的頻率。在使用傅立 葉轉換紅外線光譜儀,而無樣品的情況下,干擾的來源加上光學路徑的氣體含量首先被偵測到。然後樣品被放置在光束和干擾器中來記錄現象。在有或無樣品的存在 下,干擾的轉換告知光的頻率到達偵測器。一個全範圍的波長 之兩個干擾轉換的差異構成了傳送光譜。

高溫水平爐管 2
Conventional Thermal annealing 2
儀器管理員:邱世明
聯絡電話:(04)22851549#905
儀器概述
- 當所需氧化層厚度很厚,且對氧化層電性要求不高時,濕式氧化法氧化速率較快,可節省製程時間,主要的應用如LOCOS 的Field Oxide(5500Å)。Si + H2O -> SiO2 + 2H2
- 乾式氧化法長出的Oxide 具較佳氧化層電性,且所需厚度不厚時,都可用乾式氧化來製作。如Gate Oxide及Pad Oxide(300Å)。Si +O2 -> SiO2
注意事項
- 唯一可以進金屬,破片的爐管。
- 退火並非沉積薄膜製程,是利用適當之熱處理條件使發生回復、再結晶與晶粒成長之過程。
- 若金屬導線為鋁時,溫度不可超過450 ℃以避免金屬融化。
- 此Tube可選擇通入氣體種類有:O2,Ar,N2 ,惟通入量之單位為SLM (liter/minute),故製程階段O2,Ar通入量勿超過6SLM,以避免浪費與氣體於製程階段耗盡。

電漿輔助化學氣相沈積 2
PECVD 2 (Plasma Enhance Chemical Vapor Deposition)
儀器管理員:邱世明
聯絡電話:(04)22851549#905
儀器概述
- ECVD系統使用射頻(radio-frequency,簡稱RF)電源供應器提供RF電磁波(13.56MHZ) 產生電漿,而腔體內部是以上下兩片極板所構成,此兩片極板通常為鋁製電極,晶片則是放 置於下方電極基板上。
- 兩個電極間外加一個射頻(RF)電壓時,兩極間會有輝光放電現象。製程氣體則由上方極板 通入進入兩極板間的輝光放電區域,而製程所 產生之癈氣則由抽氣幫浦抽至癈氣處理系統。

快速退火升溫爐
RETA(Rapidly Enhanced Temporature annealing)
儀器管理員:蘇育右
聯絡電話:(04)22851549#902
儀器概述
快速熱退火處理系統,主要是利用快速升降溫的方式對晶片做有效的熱處理,並減少雜質的外擴散效應,較傳統的爐管減少許多熱運算。同時,通入O2後,此系統具有長薄氧化層的功能(RTO)。目前機台使用的溫度範圍600~12000C,升溫速率 <1000C,4吋晶片為主。
注意事項
在最高溫度1200℃持溫不要超過3分鐘,1000℃持溫不要超過20分鐘,需長時間高溫者請用傳統高溫爐,以免熱電偶及燈管老化。
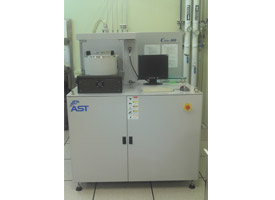
反應性離子蝕刻
RIE(Reactive Ion Etching)
聯絡電話:(04)22840427#391
儀器概述
反應性離子蝕刻(Reactive Ion Etching 簡稱RIE)。最為各種反應器廣泛使用的方法,便是結合(1)物理性的離子轟擊與(2)化學反應的蝕刻。此種方式兼具非等向性與高蝕刻選擇比等雙重優點,蝕刻的進行主要靠化學反應來達成,以獲得高選擇比。
注意事項
- 在使用前先檢查冷卻水、電、高壓氣體(CDA=0.5Mpa)、氮氣(GN2壓力1kg/cm2以上),製程氣體(包跨PN2,O2,CF4…要在1kg/cm2以上),製程氣體使用完畢請記得關上。
- 開機時先讓Turbo熱機,需要15分鐘以上。
- 盡量避免使用易碎裂晶片或過小晶片,切割過的晶片請清洗乾淨避免碎片吸至Turbo,導致機器損毀。
- 上下電極功率最大各為1KW和100W,在設定功率的使用上請勿超過最大值的一半。
- 開啟腔門要等大氣壓力為一大氣壓時(7.5*102torr以上)才使用DOOR UP。
- 樣品取出後腔體門不要開太久,如有下一個樣品請盡快放入。
- 使用中不可突然關電源,會造成Turbo故障。
- 本機台不使用手動控制,一切以自動控制為主。
- 請使用者要記得上下反射功率跟CP,CL值是否有異常,有異常請回報。
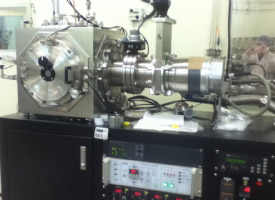
磁控濺鍍設備 2
RF Magnetron Sputter Deposition System 2
儀器管理員:楊育哲
聯絡電話:(04)22851549#506
儀器概述
沉積原理:
- 將鈀材固態材料加熱昇華到氣態。
- 將氣態的原子,分子,或離子加速通過一個高度真空的空間,到達附著的基板表面。
- 將鈀材材料在欲鍍面的表面沉積形成薄膜。
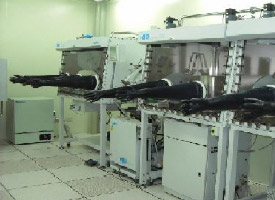
手套箱
GLOVE BOX
儀器管理員:賴冠宇
聯絡電話:(04)22851549#506
儀器概述
- 充氮氣(purge)
- 循環(circulation)
H純化機;觸媒槽(purifier)
銅觸媒 → 吸附氧氣 分子篩 → 移除水分子 - 再生(regeneration)
再生氣體: 5%H2+ 95%%N2 混合氣體
H反應後產生水氣排出

電漿輔助化學氣相沈積
PECVD 1 (Plasma Enhance Chemical Vapor Deposition)
儀器管理員:蘇育右
聯絡電話:(04)22851549#902
儀器概述
- PECVD系統使用射頻(radio-frequency,簡稱RF)電源供應器提供RF電磁波(13.56MHZ) 產生電漿,而腔體內部是以上下兩片極板所構成,此兩片極板通常為鋁製電極,晶片則是放 置於下方電極基板上。
- 兩個電極間外加一個射頻(RF)電壓時,兩極間會有輝光放電現象。製程氣體則由上方極板 通入進入兩極板間的輝光放電區域,而製程所 產生之癈氣則由抽氣幫浦抽至癈氣處理系統。
注意事項
- 注意機台供水、電及氣狀況。
- 注意機台目前的狀況-PUMP、valve、RF、加熱器..等。
- 設定電漿系統,並注意反射功率不得10 %。
- 每次實驗後必須使用無塵擦拭紙沾酒精做腔體清潔。
- 以吸塵器清潔乾淨,尤其是電極板處的氣體流出洞,請確保無殘留酒精。
- 注意使用的射頻產生器規格(13.56MHz或40.68MHz)
- Heater:實際溫度70℃以下才可破真空。
- 抽真空時注意腔體壓力,壓力到達時才可切換抽氣程序。

熱蒸鍍機
Thermal Evaporation Coater
儀器管理員:蘇育右
聯絡電話:(04)22851549#902
儀器概述
- 蒸鍍(Evaporation)系統是利用被蒸鍍物在接近其熔點時所具備的飽和蒸氣壓,來進行薄膜的沉積。
- 以高電流通過耐熱的鎢舟,藉以電阻生熱的方式將欲鍍物加熱,當溫度上升至欲鍍物的熔點時,便開始熔融,並在反應室中開始氣化,當蒸氣接觸到晶圓表面時,就會再度凝結,並在晶圓表面形成薄膜。
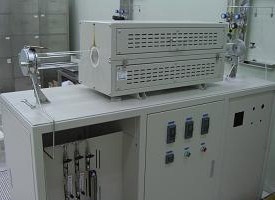
高溫水平爐管 1
Conventional Thermal annealing 1
儀器管理員:周敬添
聯絡電話:(04)22851549#725
儀器概述
- 當所需氧化層厚度很厚,且對氧化層電性要求不高時,濕式氧化法氧化速率較快,可節省製程時間,主要的應用如LOCOS 的Field Oxide(5500Å)。Si + H2O -> SiO2 + 2H2
- 乾式氧化法長出的Oxide 具較佳氧化層電性,且所需厚度不厚時,都可用乾式氧化來製作。如Gate Oxide及Pad Oxide(300Å)。Si +O2 -> SiO2
注意事項
- 唯一可以進金屬,破片的爐管。
- 退火並非沉積薄膜製程,是利用適當之熱處理條件使發生回復、再結晶與晶粒成長之過程。
- 若金屬導線為鋁時,溫度不可超過450 ℃以避免金屬融化。
- 此Tube可選擇通入氣體種類有:O2,Ar,N2 ,惟通入量之單位為SLM (liter/minute),故製程階段O2,Ar通入量勿超過6SLM,以避免浪費與氣體於製程階段耗盡。
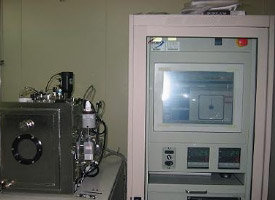
磁控濺鍍設備 1
RF Magnetron Sputter Deposition System 1
儀器管理員:黃家城
(04)22851549#725
儀器概述
沉積原理:
- 將鈀材固態材料加熱昇華到氣態。
- 將氣態的原子,分子,或離子加速通過一個高度真空的空間,到達附著的基板表面。
- 將鈀材材料在欲鍍面的表面沉積形成薄膜。
注意事項
- 使用者須通過檢定才可使用,見習3次,筆試與上機操作。
- 人機畫面為接觸式介面,請勿以筆尖或尖銳物品操作。
- 注意機台目前的狀況,傳輸機構,PUMP,valve,RF,水,電,氣……。
- 閥門顏色-紅色表示動作中;綠色表示未動作。
- 勿單獨作業